UEV: vers une miniaturisation électronique inégalée
Publié par Adrien,
Source: Cette information est un extrait du BE Etats-Unis numéro 53 du 27/10/2006 rédigé par l'Ambassade de France aux Etats-Unis. Les Bulletins Electroniques (BE) sont un service ADIT et sont accessibles gratuitement sur www.bulletins-electroniques.com
Illustration: IntelAutres langues:
Source: Cette information est un extrait du BE Etats-Unis numéro 53 du 27/10/2006 rédigé par l'Ambassade de France aux Etats-Unis. Les Bulletins Electroniques (BE) sont un service ADIT et sont accessibles gratuitement sur www.bulletins-electroniques.com
Illustration: IntelAutres langues:
3
Restez toujours informé: suivez-nous sur Google Actualités (icone ☆)
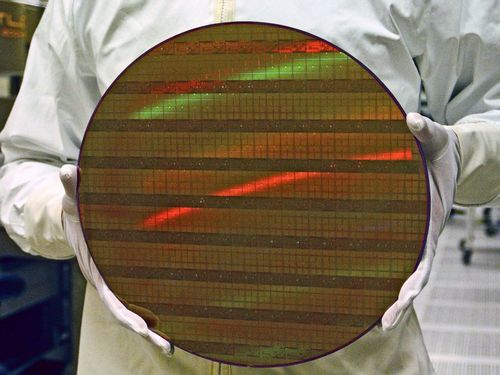
Wafer Intel en 45 nanomètres
La miniaturisation est actuellement la clé de l'augmentation
de la puissance des microprocesseurs
Lors d'une présentation programmée à l'occasion du 5ème colloque international sur la lithographie EUV qui s'est tenu à Barcelone du 15 au 19 Oct. 2006, des chercheurs de l'Université de Floride à Orlando (UCF) ont indiqué qu'ils avaient réussi à coupler un laser de forte puissance à un laser de source plasma, créant un outil efficace pour l'usage d'EUV. La source de lumière produite était d'une puissance 30 fois supérieure à ce qui se faisait d'ordinaire.
Cette technologie unique développée par UCF repose sur une conversion de la lumière laser en EUV, avec une élimination efficace des particules neutres et chargées qui sont associées à la source plasma. L'étude a été menée avec l'aide de Powerlase Ltd, une entreprise anglaise qui a fourni aux chercheurs le laser de forte puissance.
Ces travaux de recherche ont été dirigés par le Professeur Martin Richardson, Directeur du Laser Plasma Laboratory à UCF. Son équipe travaille sur les applications des lasers haute puissance et particulièrement le développement de source de lumière EUV et des systèmes optiques à rayons X avancés.